在BGA返修焊接中心,非接触红外温度传感器实时对被返修的元件进行温度测量,并实时把温度数据反馈给微处理器;微处理器把实时测得的温度与焊膏的理想温度曲线进行比较,来调整顶部红外加热器及底部红外加热器的功率,使被返修元件的温度始终跟踪理想的温度曲线。由于返修焊接关心的是焊点的温度,所以系统在温控上,通过采集PCB线路板上下温度,使其均按回流温度曲线控制。
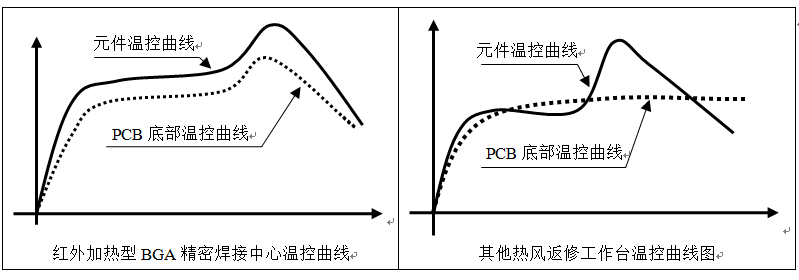
红外加热型BGA精密焊接中心的优点归纳如下:
1.红外返修过程中,BGA表面温度均匀分布更均匀。下图的实际测试证明,BGA、CSP元件表面温度分布非常均匀(颜色越深表示温度越高)。
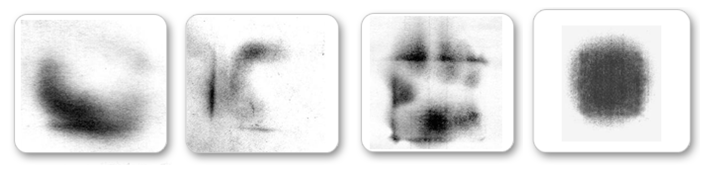
BGA返修台红外加热与热风加热均匀度对比(最右为红外加热)
2. 没有热风返修系统所必须的喷嘴,不仅使用方便而且节省了喷嘴成本。
3. 系统是开放式结构,不仅可以用焊料熔点来对温度曲线进行校正,而且器件的整个解焊和焊接回流过程可以清晰的看到,使回流工艺过程实现了可视化。
4. 由于没有热气流对器件的作用力影响,器件表面温度分布均匀,BGA、CSP焊接不会出现位置倾斜和偏移。
5. 拆除底部有填充胶的CSP元件已不再困难,由于没有喷嘴的阻挡,焊点熔化就可以用一个小镊子把元件取下来。
6. 拆除及焊接异形元件十分方便,如长条形连接器及各种形状的屏蔽罩。
7. 容易实现无铅返修工艺,因为温度能精确控制及加热温度均匀,适应了无铅焊工艺的要求。
8. BGA、CSP的植球一次成功。在回流焊接温度下,器件上的小锡球充分熔化,且由于液态焊料的表面张力作用,小锡球自动对准排列整齐。没有了气流力的作用,小球不会滚到一起形成短路,植球质量极佳。
9. BGA、CSP返修工艺具有良好的可重复性。 由于焊膏供应商对焊膏特性了解最清楚,他们提供的回流焊曲线是十分理想的,只需输入这条回流焊曲线,系统就自动控制IC元件与PCB线路板底部的红外线加热器,按回流焊曲线进行加热。
红外加热型BGA精密焊接中心已在很多电子组装工厂中使用,在SMT尤其是BGA、CSP的返修工作中,已显示出众多的优越性。
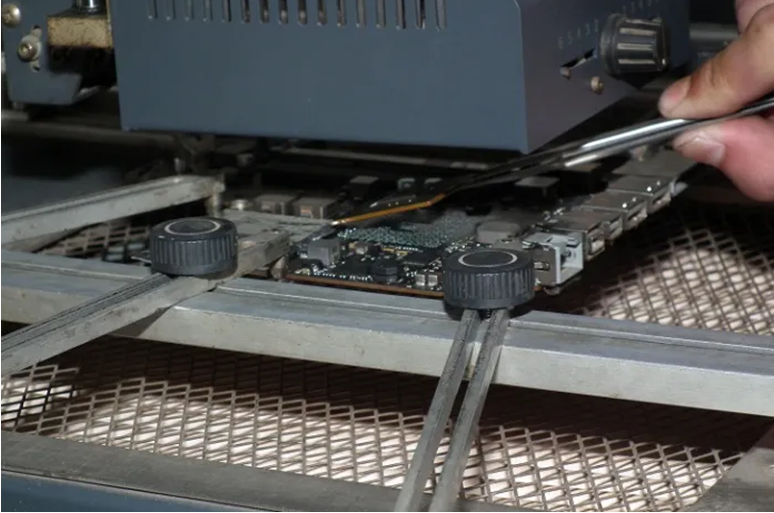
图片来源网络


